ダイシング加工
Dicing Proccess
最適な加工技術でチッピングを
抑えた高品質なカットを提供します
ウェハのチップ化は、ダイシング加工の工程が欠かせません。ウェハの状況や設計要求事項によって、シングルカット・ステップカットその他 特殊カット仕様の立ち上げ経験をもっています。ダイシング加工に使用する機械は全て2軸機を保有しております。ウェハにより最適なブレード、条件を選定し、チッピング を抑制したダイシング加工を基本技術として生かしています。
SiC、アルミナセラミック、メタル膜付WFについては、 レーザーダイシング装置を使用し、高品質にカットいたします。
半導体ウェハ1枚からのダイシング加工試作も承ります。お気軽にお問合せください。

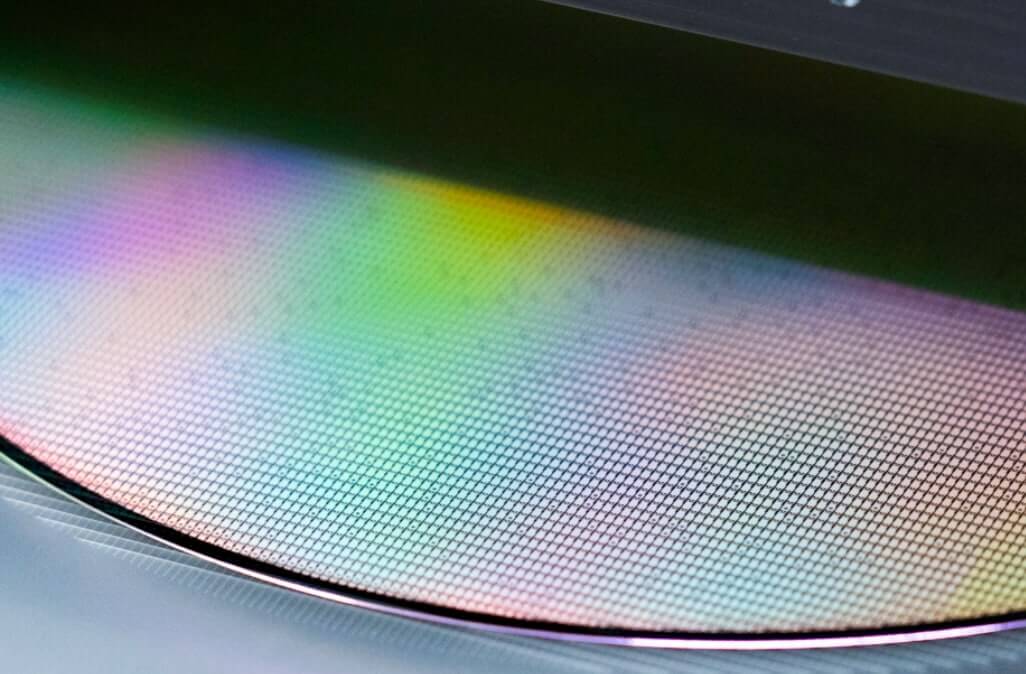
テープマウントされたウェハを高速回転のダイヤモンドブレードにて、個片状態に切り分けます。その際、切削用として、超純水をブレード、ウェハに掛けながらカット・加工します。
Dicing
ダイシング加工の特長
01
特長01高度な加工技術
ダイシング加工対応可能な素材が豊富
-
ガラス
無アルカリガラス、テンパックスガラス、ホウケイ酸ガラス、サファイアガラス、青板ガラスなど
-
セラミック
アルミナ、窒化ケイ素、SiCなど
-
シリコン
パターン付き、ミラーウェハなど
-
その他
ガラスエポキシ(ガラエポ)、ポリカーボネート、アクリル、各種金属(SUS等)、ゴム、タンタル酸リチウム基板(LiTaO3基板)など
ダイシング加工対応可能な素材が豊富



加工可能なウェハサイズ・厚み、チップサイズ
-
加工できるもの
・シリコン ・化合物半導体 ・セラミック
・各種ガラス ・樹脂(ガラエポ等) -
加工が難しいもの
・金属厚板(薄膜等、一部加工できるものあり)
※ただし、レーザーにて切断できる可能性あり(外部協力会社にて) -
加工可能サイズ
・直径300mm以下
-
加工可能厚み
・2mm以下(ただし、ワーク種類による)
02
特長02高品質な加工技術
1
チッピングの発生を無くし、様々なスクライブ幅に対応した加工技術
チッピング対策ノウハウも豊富に保有しており、セラミックやガラスもキレイにチッピング無しで切断することが可能。
チッピング対策改善例
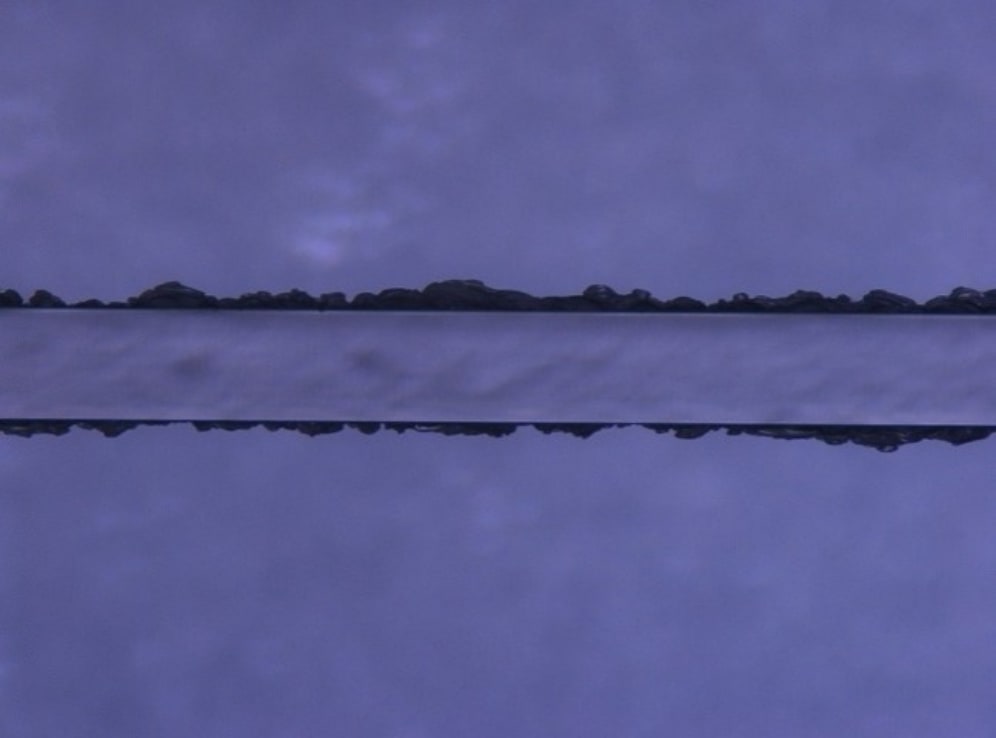
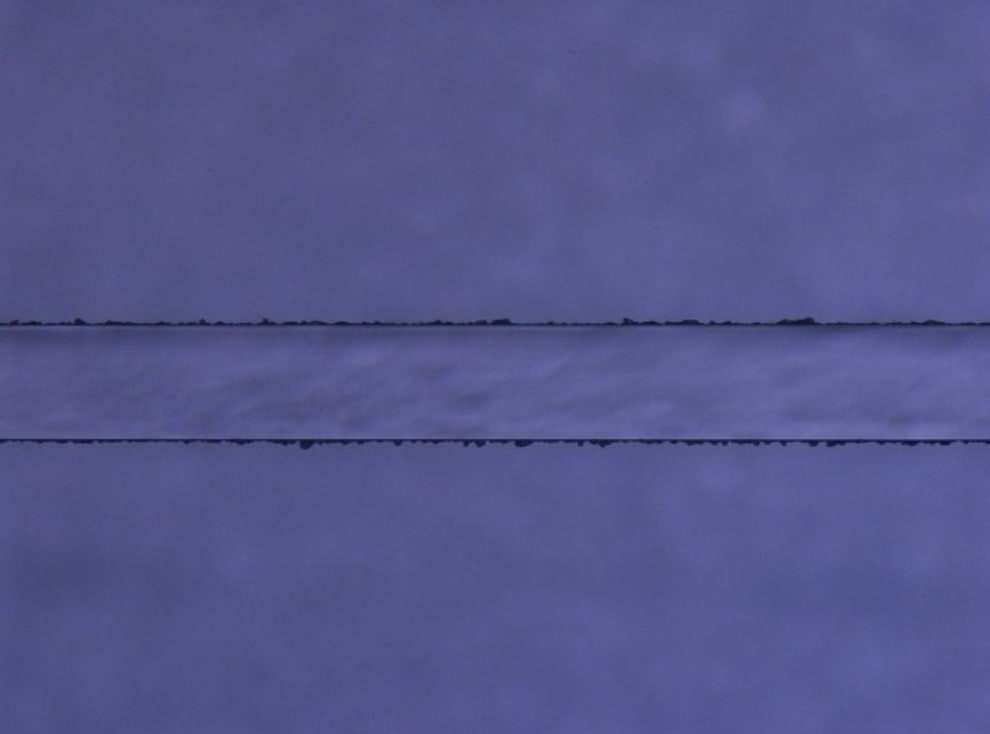
2
様々なスクライブ幅に対応
様々なブレード、条件を用意しておりますので、広いスクライブ幅(150μm)から狭いスクライブ幅(40μm以下)までダイシングが可能です。 デュアルステップカットにより裏面チッピングの発生もありません。
3
アルミパッドの腐食防止
ダイシングでは、純水を掛け続けながら切削を実施するため、アルミパッドの腐食が発生する場合があります。 ニチワ工業では、切削条件、純水の改善により様々な腐食、汚れを防止するノウハウを持っております。
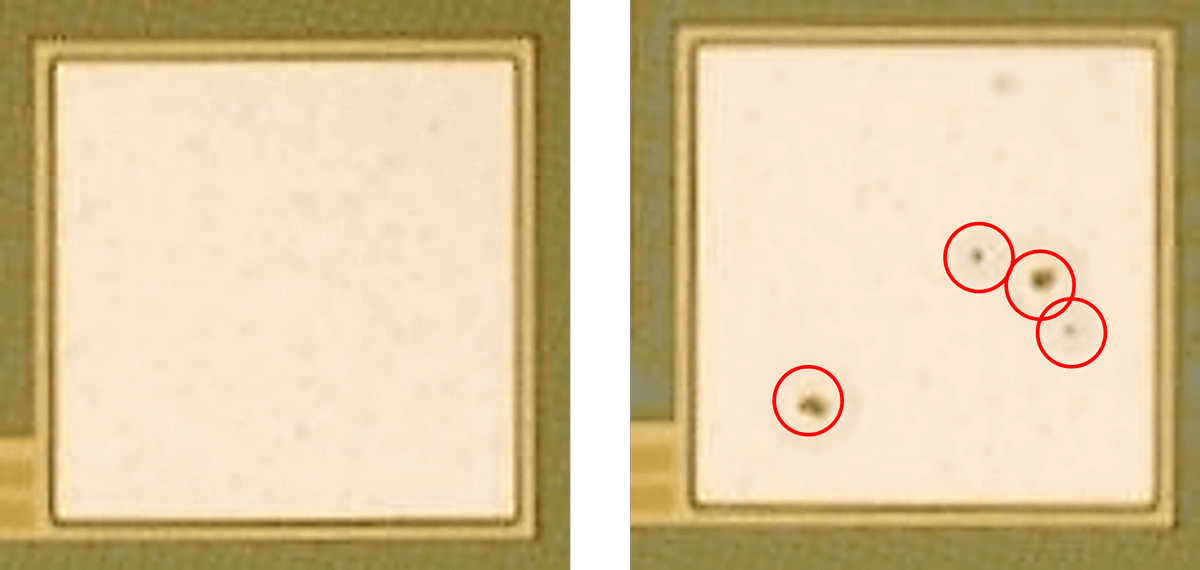
4
高度な寸法精度
お客様の要求に対応すべく、精度の高いダイシング加工を提供しております。
- ダイシングのカットライン精度・・・±3μm
- ダイシングのチッピング幅・・・10μm以下
03
特長031個からでも対応
Dicing Proccess
当社では、1個からダイシング加工を承っております。
各種素材の加工実績・ノウハウがありますので、お気軽にご相談ください。
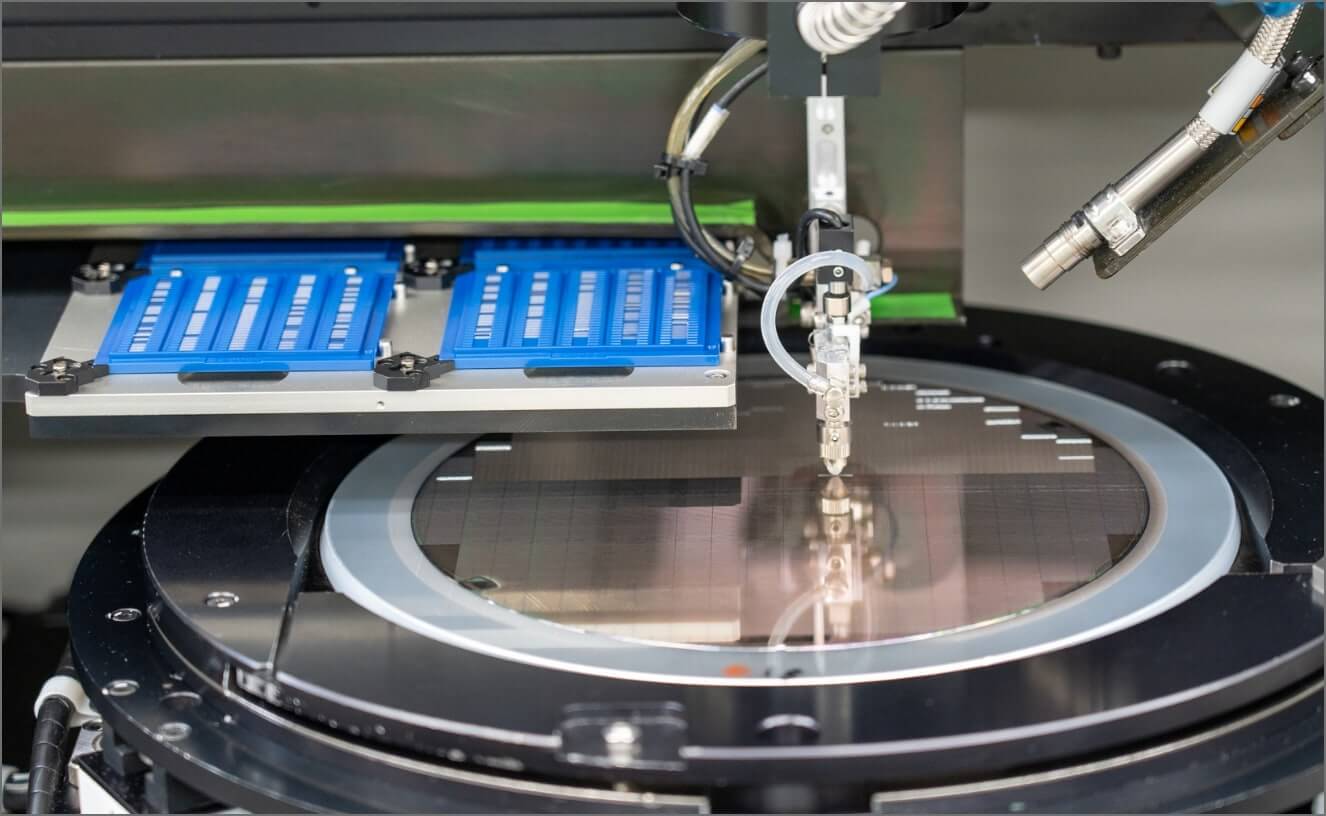
レーザーダイシング
SiC、アルミナセラミック、メタル膜付ウェハを
高品質にカットいたします
従来のレーザー加工と違い、焦点合わせの必要が無く、平行なビームで加工が出来ます。
また、レーザーマイクロジェットでは、絶え間なく流れる水ジェットにより、加工物が効率良く冷却され、熱影響を抑える事が出来ます。
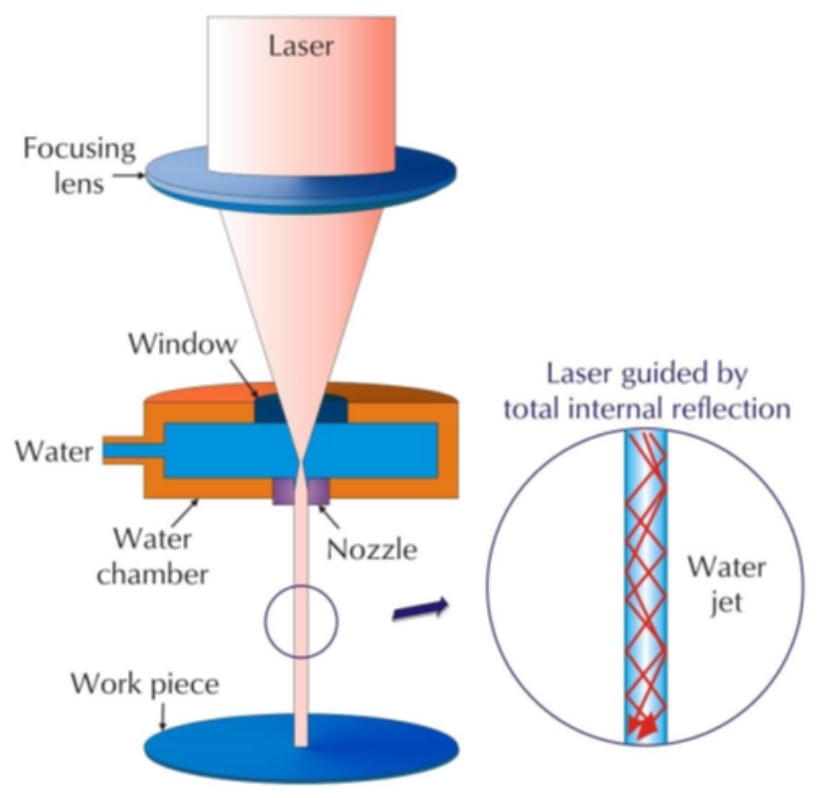
レーザーダイシング技術について
レーザーダイシングには下記の加工方式がございます。
- アブレーション方式
レーザー光で材料表面を直接蒸発・除去(アブレーション)しながら溝を形成して切断
加工熱影響が局所的だが切断面の品質が荒れやすい
シリコン、ガラスなどに使用 - ステルスレーザー方式
ウェハ内部にレーザーを集光し、内部に微細なクラック・ダメージ層を形成
その後、テープ剥離時や外力で割って切断する方式
保有装置設備
| 設備 | 対応サイズ | 加工幅 (ノズル直径≒加工幅) |
台数 |
|---|---|---|---|
| レーザーダイサー | 4~8インチ | 30、40、50、60、70、80、100μm | 1 |
バックメタル付きウェハに最適
表面部をブレードで加工し、裏面メタル部をレーザーマイクロジェットで加工する事により、メタル部のバリやヒゲの発生を大幅に 抑制する事ができます。
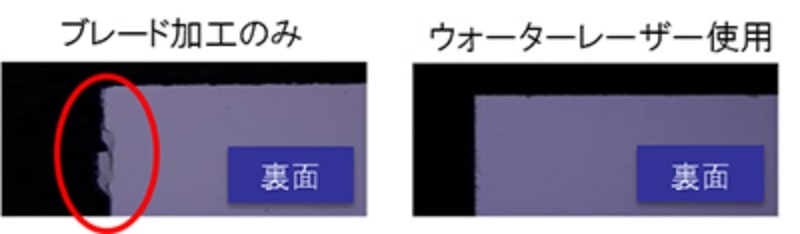
よくある質問
素材に関する質問
加工可能です。
加工可能です。
一部を除き加工不可です。詳しくはご相談ください。
材料によっては難しいものもありますが、過去に実績があります。
GaAsは加工不可となりますが、SiC、GaN、酸化ガリウム等の化合物半導体は加工可能です。
加工可能です。
カケが発生しやすいですが、加工可能です。
サイズや厚さに関する質問
最大でΦ300mmの円に入るサイズになります。最小では3mm以下のものについてはご相談ください。
凡そ2mm以下であれば対応可能です。
Si、ガラス等については対応可能です。その他は素材によって異なりますのでご相談ください。
最大でΦ300mm(12インチ)が可能です。
オプションに関する質問
裸眼、もしくは顕微鏡(金属顕微鏡、実体顕微鏡)を使用した検査員が外観検査を実施いたします。ウェハ状態、ダイシング切断状態、チップトレイに収納された状態であれば外観検査装置も保有しております。
対応可能です。
対応可能です。
対応可能です。
使用可能です。
特殊なダイシング加工に関する質問
±10μm程度(実力的には±5μm)の精度でダイシングが可能です。
カット方法、部材、超音波ダイシング等を改善し、抑制が可能です。詳しくはこちらの資料をご覧ください。
カット方法、部材、超音波ダイシング等を改善し、抑制が可能です。
対応可能です。ご相談ください。
一部を除き対応可能です。ご相談ください。
対応可能です。
条件次第で対応可能です。
その他
10~300μm幅であれば各種ブレードの保有があります。
Contact
ダイシング加工やバックグラインド、ガラスTGVなどのお問い合わせはこちらから

ダイシング加工を始めとした
技術情報を多数掲載!
資料ダウンロード
ダイシング加工を始めとした
技術情報を多数掲載!
