加工事例
薄いシリコンウェハのダイシング加工
- ダイシング
- トレイ詰め
- バックグラインド
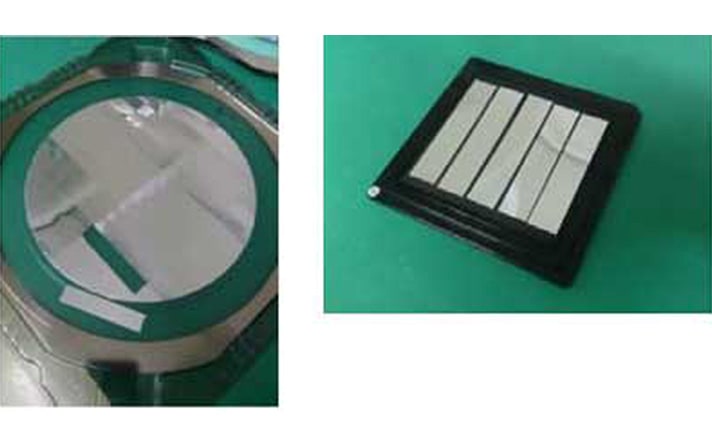
製品概要
- 材料
- シリコン
- サイズ
- 約10mm×60mm t=50μm
- 加工納期(目安)
- 2日
- 加工方法
- バックグラインド、ダイシング加工、トレイ詰め
- 製品・業界
- 研究、開発
- 特徴
- 薄ウェハの加工
基礎情報
シリコンウェハについて
シリコンウェハは半導体デバイスの基盤となる最もポピュラーな材料で、集積回路の形成に欠かせません。直径や厚さが用途に応じて規格化されており、微細加工が可能な高い結晶性と安定した特性を持ちます。ICチップやセンサー製造の出発点となる重要素材です。
シリコンウェハのダイシング加工
薄化されたウェハは強度が低いため、加工時に割れや欠けが発生しやすくなります。特に微細チップ用途では大きな課題です。
加工に必要な技術と設備
薄いウェハの加工には、高精度ダイシングソーやレーザーダイシング装置が不可欠です。クリーンルーム環境での異物管理や、冷却技術も重要です。設備性能に加え、条件最適化や工程設計のノウハウが成功の鍵となります。
薄化ウェハ特有の難しさ
厚さ50µm以下の薄化ウェハは、わずかな応力や衝撃でも破損するリスクがあります。さらに、取り扱いや搬送の段階でも欠損が生じやすいため、単に切断技術だけでなく、搬送・固定方法や全面工程の総合的な工夫が不可欠です。
加工事例詳細
お客様の要望
薄化後のシリコンウェハを割れや欠けなく高精度にチップ化したいという依頼がありました。特に、厚さ50µm以下のウェハを安定的にダイシングできる加工条件を求められ、量産に耐えうる歩留まりの確保が大きな課題でした。
ニチワ工業の技術力
薄ウェハを切断する際は、ウェハにかかる応力を最小限に抑えることが重要です。刃の回転数や送り速度を調整して低応力で切断し、柔軟性のあるテープでウェハをしっかり支えることで反りやたわみを防ぎます。また、チッピングの発生が少ないブレードを使用するなど、ダメージを抑える工夫も行います。
チップを取り出す際は、ウェハやチップに応じて調整して割れや表面損傷を防ぎます。搬送時の振動や衝撃を抑える柔軟な治具を使い、さらに薄ウェハの反りやたわみに対応する補助治具で安定させることで、安全にチップを取り出せます。
結果
最終的に、50µm以下のウェハでも高い精度で割れ率1%未満を達成し、チップ寸法精度も顧客仕様を満たしました。従来課題だった反りや欠損も大幅に改善され、歩留まりが向上。また、個片化したチップのトレイ詰めまでの工程を当社で行い、お客様の課題解決や手間の削減に貢献しました。
技術情報リンク
関連する加工技術の詳細はこちらのページをご覧ください
ダイシング加工Contact
ダイシング加工やバックグラインド、ガラスTGVなどのお問い合わせはこちらから

ダイシング加工を始めとした
技術情報を多数掲載!
資料ダウンロード
ダイシング加工を始めとした
技術情報を多数掲載!